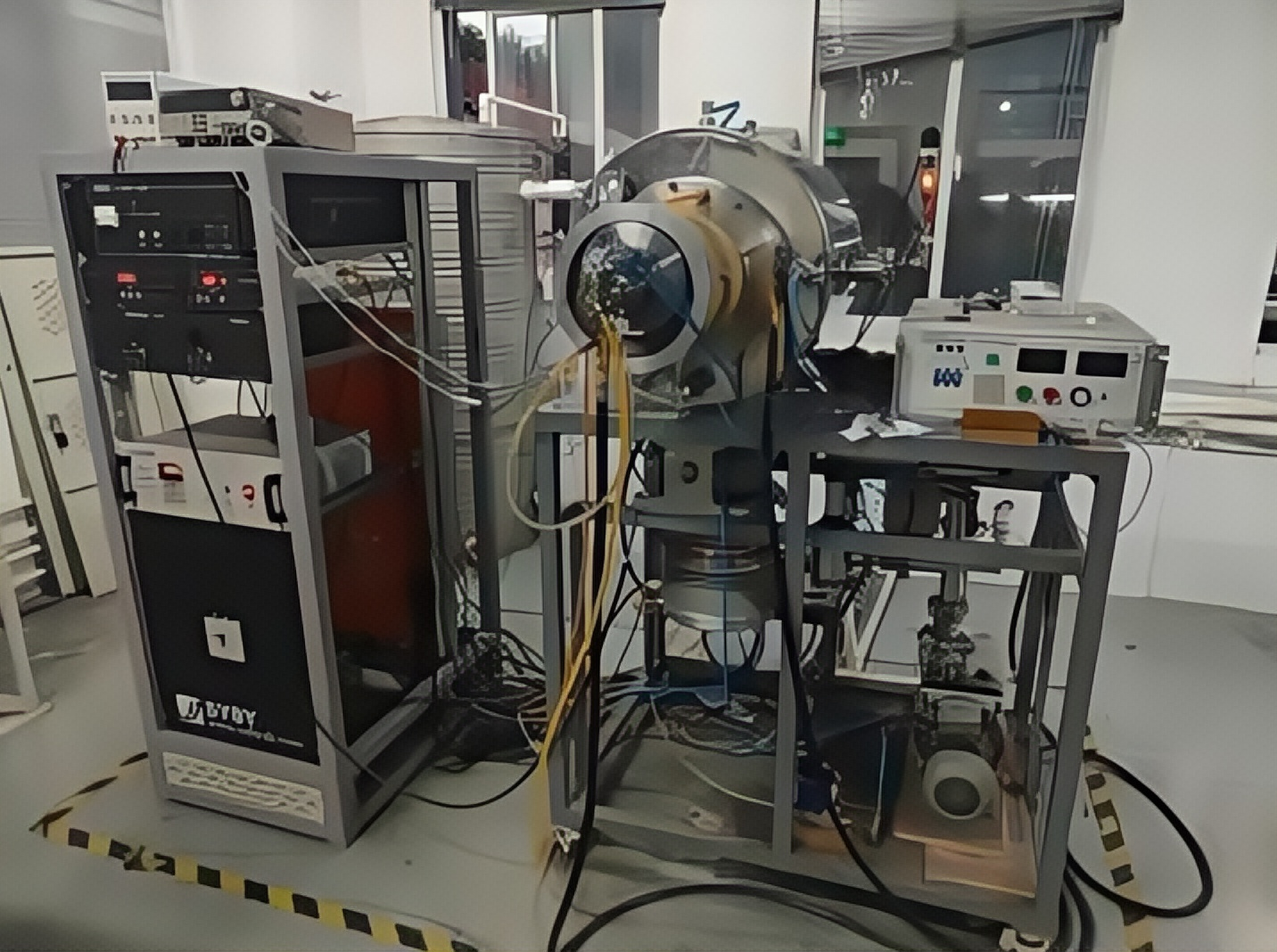
产品分类:真空设备技术和产品
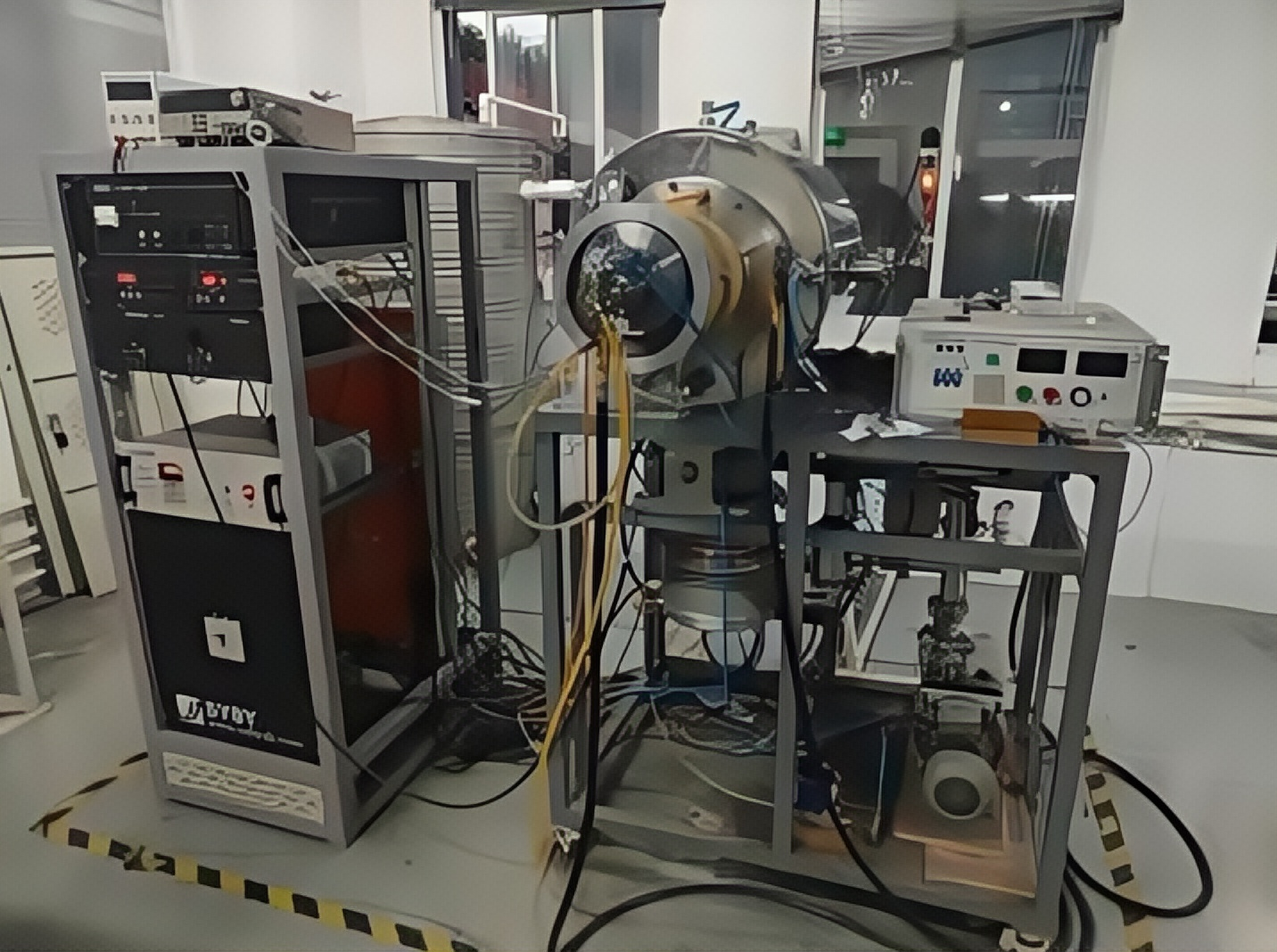
利用直管过滤弧制备类金刚石薄膜改变磁场分布及阻挡结构对大颗粒参数影响的应用实例
实验中弧源磁场分为靶材后部永磁体磁场以及管壁外电磁线圈磁场两部分,靶材后部永磁体为环状永磁体,仅考虑永磁体磁场的条件下,磁环内径对靶面垂直磁场影响较大,磁环内径越大靶面垂直磁场的差值越小;磁环外径对垂直磁场影响相对较小,磁环厚度对垂直磁场强度影响相对最小,增加部分的永磁体在靶面产生的随着厚度增加越来越小。当永磁环厚度与宽度一定时,永磁环内径越大靶面水平磁场越大,垂直磁场差值越小。
实验中永磁体型号为N35,外径40 mm、内径20 mm、厚度10 mm。线圈磁场与永磁环在靶面产生的磁场相反,在安装永磁体后永磁体与线圈磁场在靶面耦合形成拱形磁场。实验在固定偏压、占空比、沉积时间的条件下改变磁场并根据阻挡结构的有无设置自变量。
图3为制备出的类金刚石薄膜表面及截面形貌;图4、图5为大颗粒数量及平均尺寸变化折线图。由图可知在不同磁场条件下大颗粒数量具有不同的变化趋势,在设置永磁体的情况下大颗粒数量的两条曲线随着线圈电流的增加均出现了轻微的上升趋势。具有永磁体且线圈电流大于1 A时,随着线圈电流的增大,靶面水平磁场逐渐增大,磁场零点向靶面中心移动,靶面轴线处水平磁场强度为零,在边缘处出现最大值,磁场分布如图2所示。在具有永磁体的情况下随着线圈电流的增大弧斑越倾向于靠近靶面轴线运动,由于大颗粒倾向于与靶面的小角度方向运动,同时石墨靶发射出的离子束聚焦程度高,磁场强度的增加会提高聚焦程度,降低了阴极等离子的扩展程度,提高了等离子体的阻抗,增大了弧斑发射功率,这一变化也会对大颗粒发射产生影响。综上所述大颗粒数量的增加的原因一方面是弧斑运动位置向中心靠拢增大了大颗粒逃逸的概率,另一方面是弧斑功率的提高增加了大颗粒的发射数量。
由大颗粒平均尺寸的分布曲线中可以看出,大颗粒尺寸具有随着线圈电流增加而下降的趋势,该现象与线圈磁场在靶面的水平分量有关,实验中线圈磁场在靶面的水平分量与线圈电流大小相关,线圈电流越大靶面线圈磁场的水平分量越大,靶面弧斑运动速度与靶面水平磁场强度正相关,于是线圈电流的增加加速了弧斑的运动,弧斑运动速度提高进而降低了发射出的大颗粒的平均尺寸。
仅有线圈磁场时大颗粒数曲线均出现了先降低后升高的趋势,在此条件下靶面及弧源内部空间轴向磁场强度占比较高,线圈磁场在靶材边缘具有一定的水平分量,此时弧斑更倾向于在靶材边缘运动。大颗粒平均尺寸曲线具有先升高后降低的趋势,在线圈电流为2.0 A的条件下出现了大颗粒数量较少,尺寸较大的情况,由于实验中使用的磁场强度仅能磁化电子,且大颗粒在飞行中自身质量基本不发生减少,此时大颗粒的改变主要由弧斑发射出的大颗粒决定。弧斑运动速度越快发射出的大颗粒平均尺寸越小,按此条件在只有电磁场的情况下弧斑运动速度先减少再增加,同时弧斑功率的增加相应的增加了2.0 A之后的大颗粒发射数量。
对比有无永磁体大颗粒数量曲线可以看出具有永磁体时薄膜大颗粒数量均大于仅有电磁场的情况,该现象可能为复合磁场高水平分量形成的拱形磁场导致弧斑靠近靶材轴线进而增加了大颗粒的发射数量。对比两种磁场下大颗粒平均尺寸分布可以看出在线圈电流为1.5 A时仅有电磁场实验组的大颗粒尺寸小于永磁加电磁组,复合磁场条件下永磁体磁场在靶材表面发挥主导作用,该情况下复合磁场弧斑运动速度低于纯电磁场。在线圈电流为2.0 A时仅电磁场实验组大颗粒尺寸变为大于永磁加电磁实验组,复合磁场弧斑运动速度在此范围内随着线圈电流在增大提高了弧斑运动速度导致的大颗粒的减少发挥了作用,在线圈电流为2.5 A时可以看到复合磁场条件下大颗粒平均尺寸具有进一步降低的趋势,在无阻挡条件下复合磁场平均尺寸仍低于纯电磁场。永磁体的存在改变了大颗粒数量及平均尺寸变化的整体趋势,说明永磁体的存在对弧斑运动及大颗粒发射具有较明显的影响。
图6可以看出在相同磁场条件下设置阻挡结构明显降低了大颗粒在薄膜表面的大颗粒数量,设置阻挡结构的实验组的大颗粒数量为未设置阻挡结构实验组大颗粒数量的60% ~ 70%,证明了在管道内壁设置的阻挡结构具有有效的大颗粒过滤效果。由大颗粒平均尺寸曲线可以看出具有阻挡结构实验组的大颗粒平均尺寸大于未设置阻挡结构的实验组,大颗粒数量降低但平均尺寸升高意味着过滤结构更多的过滤掉了尺寸较小的大颗粒,一种因素是较大尺寸的大颗粒面对阻挡结构的逃脱效果更强,尺寸较大意味着其具有更高的动能面对阻挡结构时更易发生反弹逃离过滤区域;另一种因素是在大颗粒产生及发射过程中靠近轴线发射出的大颗粒平均尺寸较大,更易逃离出过滤区域,而与靶材表面呈大角度发射的大颗粒平均尺寸较小,更易被阻挡结构捕获。
利用直管过滤弧制备类金刚石薄膜改变磁场分布对类金刚石薄膜sp3键含量的影响
图7为ID/IG值及sp3键含量变化折线图,在靶材后方设置有永磁体的情况下,拉曼光谱数据显示薄膜的ID/IG值随着电磁线圈电流的增加而下降,同时XPS数据中键含量曲线随着线圈电流的增加而上升,在未设置永磁体的实验组也出现了相同的现象,对比设置永磁体与未设置永磁体的键含量曲线可以看出设置有永磁体的实验组在相同线圈电流的情况下键含量均高于未设置永磁体的实验组。
该规律与磁场中的等离子体运动有关,实验中线圈电流会在靶面及靶面前方产生一个轴向磁场,轴向磁场阻碍带电粒子垂直磁力线的运动,在实验中可以观察到弧斑发射出的等离子体形成一个柱状的光束。等离子的扩展相对于无轴向磁场时有所降低,带电粒子相互作用的衰减速率相应的更加缓慢,在有磁场的情况下可以观察到离子具有更高的电荷态,磁场强度与平均离子电荷态的关系如图8所示。
电子在磁场中的磁化对离子电荷态的增加具有直接的影响,当磁场强度过高的时候离子电荷态会趋于稳定并不会进一步增加,在1 T磁场强度之前离子电荷态具有较明显的上升。实验中线圈电流产生的磁场平均强度为11.75 ~ 23.63 mT,远低于1 T,其位于离子电荷态随磁场强度增加而上升的区域,而线圈电流与电磁线圈产生的磁场强度呈正相关,即增大线圈电流会一定程度上提高弧等离子中离子的电荷态。
磁场同时也会影响离子的动能,磁场强度与磁场分布均为离子动能的影响因素。首先是绝对磁场强度的影响,磁场的存在阻碍了电子垂直于磁力线的运动,导致等离子体阻抗增强,即在相同弧电流下弧斑需要更高的电压来产生以及维持放电过程。弧斑燃烧电压的提高意味着弧斑具有更大输入功率、更高的电子温度、更高的压力梯度,最终产生了更大的离子速度,同时离子电荷态的增加与弧斑输入功率的增加近似成正比,图9为离子动能与磁场强度关系图。
实验中提高线圈电流进而增强了弧源空间的轴向磁场,碳离子电荷态与离子动能随着磁场的增加而增加,电荷态与能量的增加促进了薄膜键的生成。设置有永磁体的实验组中永磁体在靶材表面产生了更大的轴向和法向磁场分量,磁场强度的增加进一步改变了碳离子的电荷态和动能,所以相较未设置永磁体的实验组具有更高的键含量。
图1

(a)线圈电流1.0 A
图2

(b) 线圈电流2.0 A
图3

(a) 直管过滤弧制备的DLC薄膜表面形貌

(b) 直管过滤弧制备的DLC薄膜截面形貌
图4

图5
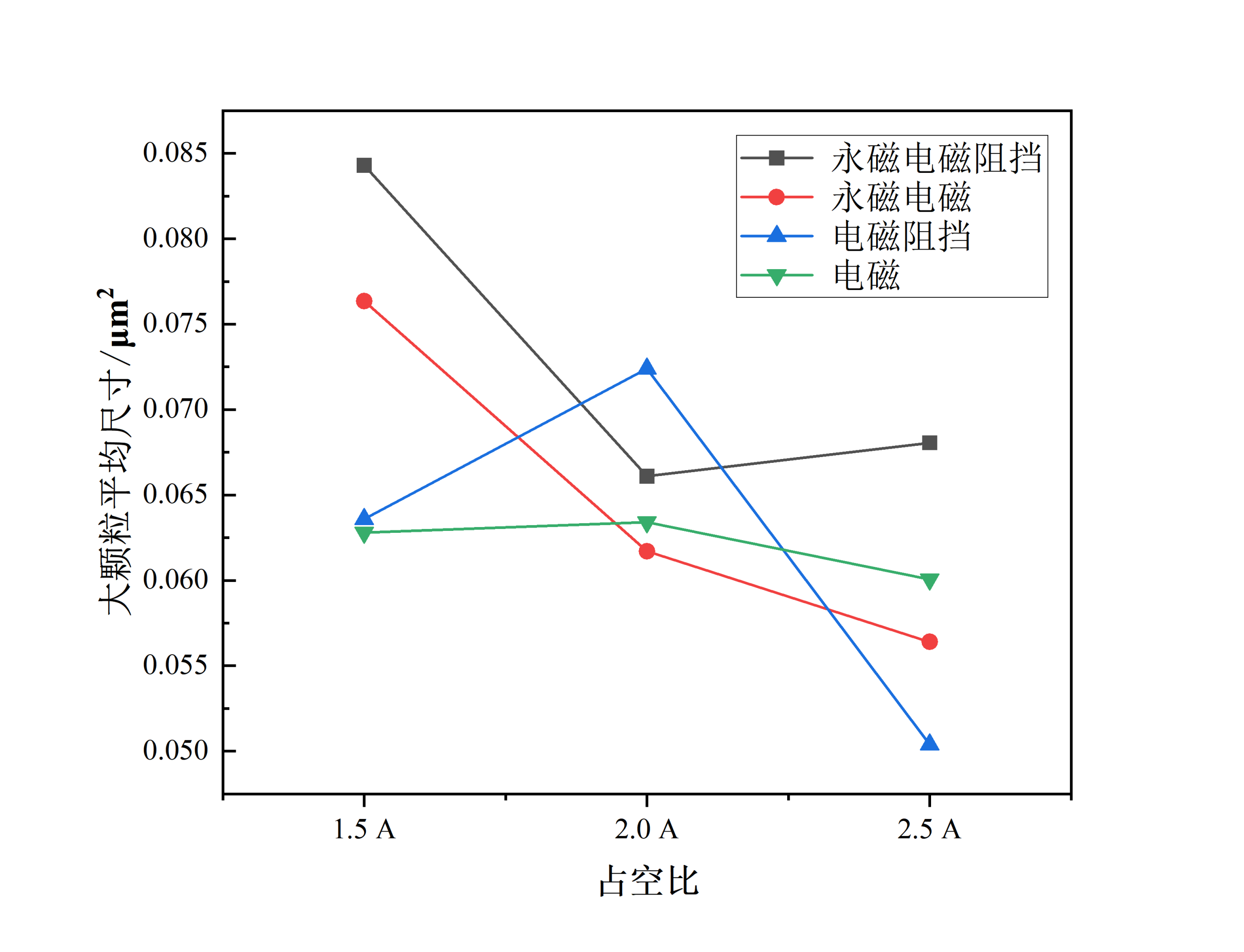
图6
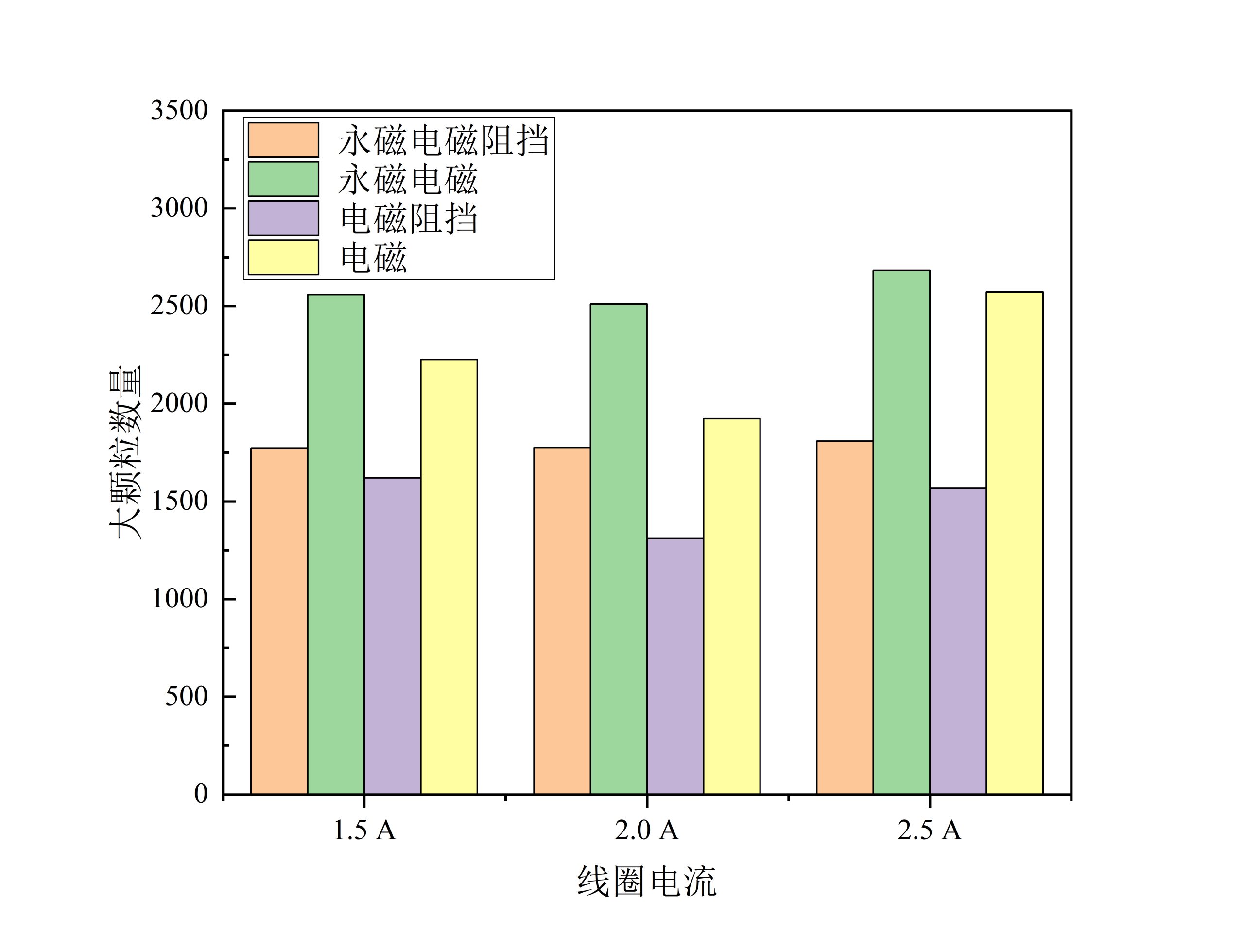
图7

图8
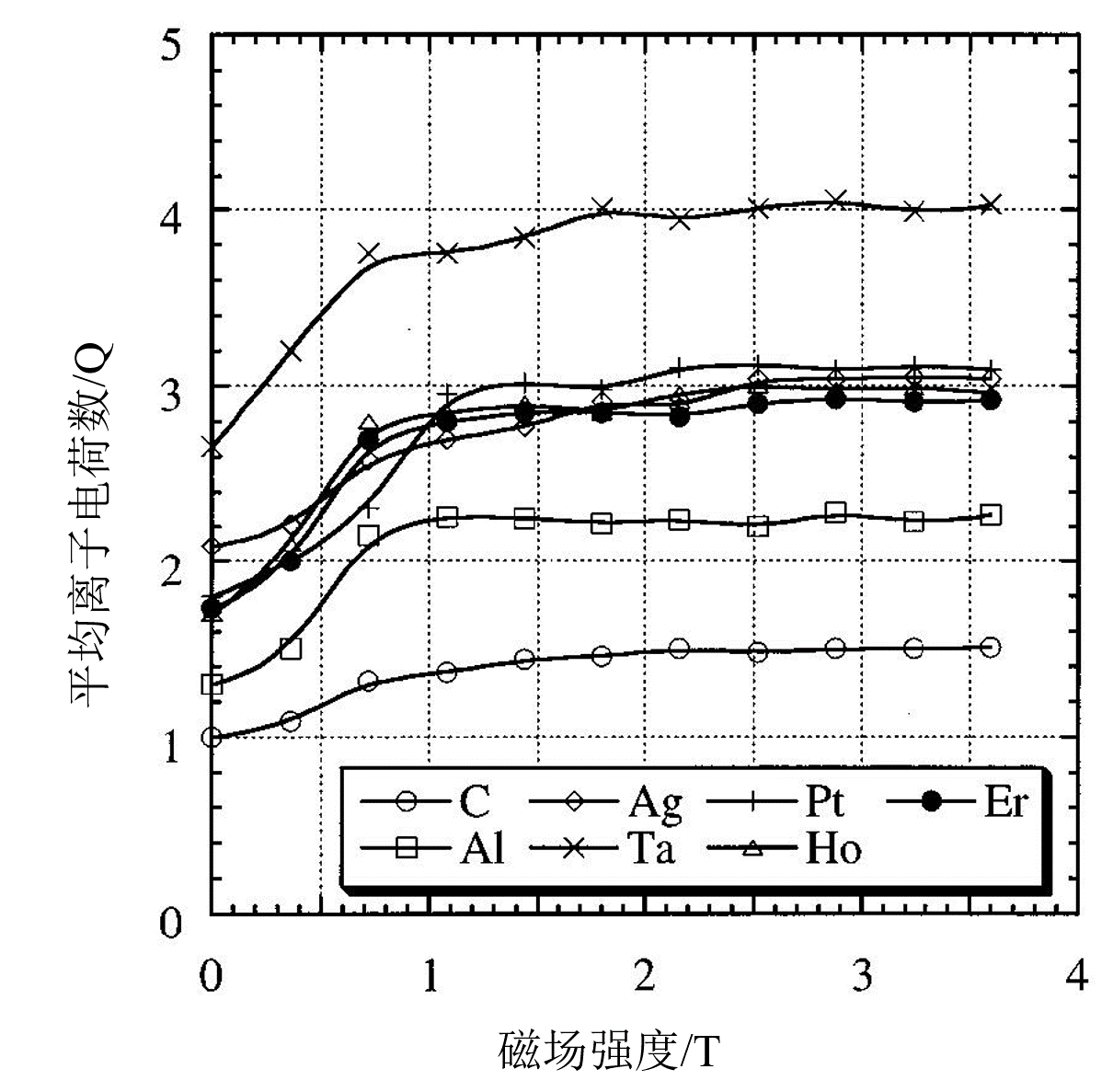
图9
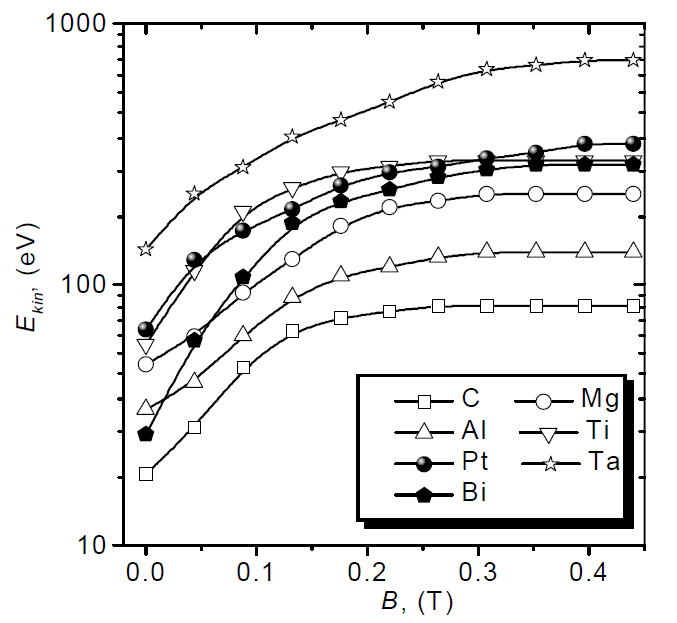
利用直管过滤弧制备TIN薄膜


对比了采用直管过滤弧与无过滤电弧两种方式制备的TiN涂层表面形貌差异,如图所示,直观展现了直管过滤结构在抑制颗粒方面的显著优势。图左为使用直管过滤弧技术沉积的TiN涂层,其表面整体平整,大颗粒显著减少,仅可见少量孤立的小颗粒,说明涂层表面质量良好。而图右为传统无过滤电弧条件下制备的涂层,其表面遍布不同尺寸的颗粒,且分布密集,大量颗粒堆积不仅降低了表面致密性,还可能成为膜层局部失效的起始点。
这种差异主要源于直管过滤弧结构对的有效筛除作用。该技术利用直线磁场通道将带电金属离子引导至基体表面,而未电离的液态微粒因质量大、动量高,在磁场作用下无法偏转运动轨迹,从而被挡留在滤弧管道之外。相比弯管结构,直管结构具有更短的传输路径和更高的离子通量保留率,既保证了沉积效率,又有效降低了颗粒污染。
因此,直管过滤弧在TiN涂层制备中表现出显著的表面净化效果,为获得致密、光滑且具有良好力学性能的膜层提供了可靠技术支持。这种过滤机制尤其适用于对表面粗糙度、摩擦性能和抗腐蚀性有较高要求的高性能功能涂层制备。
发表回复