日期:2025-07-21
姓名:孙嘉琦
摘 要:碳化硅(SiC)器件因具备高频高效、耐高压高温、抗辐射能力强以及化学性质稳定等诸多优点,在高功率电子器件、光电器件和其他高温应用领域具有广阔的发展前景。而物理气相传输法(PVT)作为目前单晶碳化硅制备中使用最多、产业化最为成熟的技术,已经有不少前人做了大量的研究。本文以PVT法制备单晶碳化硅为重点,结合近年来的研究进展,总结了PVT法制备碳化硅的工艺影响因素,包括温度分布、气氛控制、粉体纯度、工作压力和生长时间等,阐述了它们对碳化硅晶体生长的影响机理。最后,分析了目前PVT法制备SiC面临的困难与挑战,如晶体缺陷控制、应力控制、大尺寸SiC生长、P型衬底制备、成本控制等。随着碳化硅在电子器件领域需求的不断增加,如何进一步控制晶体缺陷、提升晶体尺寸以及降低生产成本,将是未来研究的重点方向。
关键词:碳化硅,SiC,物理气相传输,PVT,温度,晶体缺陷,大尺寸
一、引言
当前,为缓解全球面临的能源安全问题,实现“双碳”目标,电力电子器件正往高频化、集成化、标准模块化和智能化方向发展,而传统硅基器件的物理极限瓶颈日益凸显,难以适应未来终端应用更为复杂的电子电气架构需求[1,2]。相比之下,第三代化合物半导体材料兼具带隙大、击穿场强高、热导率大、电子迁移率大,以及抗辐射能力强等优势,可以有效地突破关键材料性能指标限制并显著提升器件效能,具有战略性和市场性双重特性,目前已成为宽禁带半导体技术研究前沿和产业竞争焦点[3,4]。
4H-SiC制备的肖特基二极管(SBD)、金属氧化物半导体场效应晶体管(MOSFET)等器件已广泛应用于电动汽车、光伏逆变器和工业电源中。相比传统的硅器件,SiC器件具有更高的效率和更强的耐高温能力。SiC材料具有优异的紫外响应特性,广泛应用于紫外探测器和发光二极管(LED)等光电器件中。特别是在深紫外波段,4H-SiC和6H-SiC因其较大的带隙和抗辐射能力,成为紫外探测器的理想材料。SiC的热稳定性使其在高温环境下依然保持良好的电子特性,适合用于高温传感器和电子设备中,在航空航天、汽车发动机监控等极端环境中的传感器技术中得到了广泛应用。所以高质量碳化硅单晶在高功率电子器件、光电器件和其他高温应用领域具有广泛的应用并具有广阔的发展前景。
二、碳化硅简介
碳化硅(SiC)是一种由碳元素和硅元素组成的化合物半导体,如图1所示,碳原子和硅原子以Si- C双原子层的形式组成共价四面体结构[5]。SiC实际晶体结构超过 200 多种(不同晶体结构由堆垛层的数目与晶胞中晶体的对称类型来定义),其中应用最为广泛、研究最多的是3C-SiC、4H-SiC与6H-SiC(C代表立方晶系,H代表六方晶系),对应的堆垛序列如图2所示[6]。因为4H-SiC和6H-SiC具有宽禁带、高热导率、耐高温和抗辐射等优异特性[7,8],所以在高功率电子器件、光电器件及高温结构材料领域具有重要应用[9,10]。
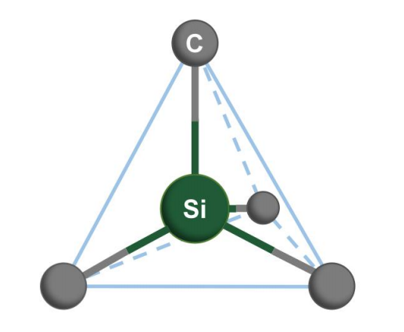
图1 SiC四面体结构[5]

图2 SiC三种不同的堆垛序列[6]
但是要充分实现以SiC为衬底的器件的优异性能,高质量单晶SiC的生长与晶片的加工技术是关键。碳化硅的制备方法多种多样,主要有物理气相传输法(PVT)、高温化学气相沉积(HTCVD)和液相法(LPE法)等[11]。其中,物理气相传输法(PVT)是最常用的单晶碳化硅制备技术之一,特别适用于制备较高质量的大尺寸单晶SiC[12]。PVT法具有工艺相对简单、成本较低、适合大规模生产等优点,已得到广泛的产业化应用,在SiC材料制备研究中占有重要地位[13]。
三、PVT法制备碳化硅的基本原理
PVT法制备SiC基于高温下碳化硅的升华和再结晶过程[14],其主要装置结构如图3所示,由石墨坩埚、SiC粉源、籽晶、感应线圈和保温层组成[15]。
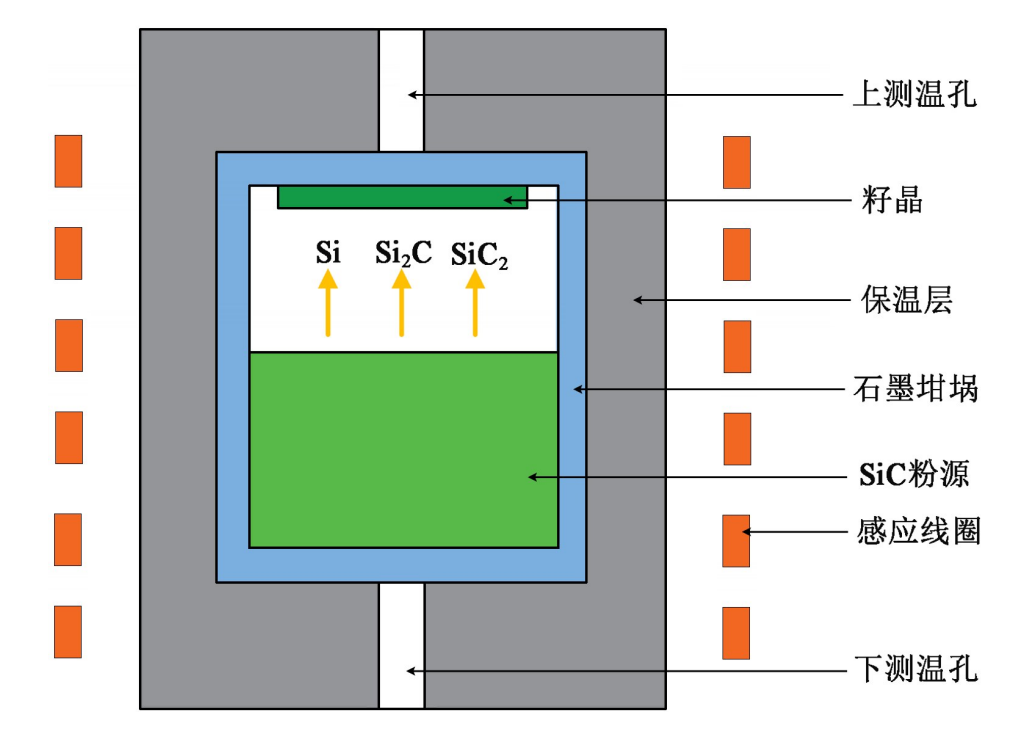
图3 PVT法生长SiC单晶装置结构示意图[15]
通常将SiC粉料置于高温石墨坩埚内,在感应线圈的涡流加热作用下,2000-3000℃的低压高温惰性气氛中,碳化硅粉料受热分解成气态硅和碳的化合物(如Si、Si₂C、SiC₂等)。所生成的气相物质在浓度梯度与压力梯度的共同作用下向低温的籽晶区域流动。在流动过程中,由于温度逐渐降低,气相物质逐渐偏离化学平衡并变得过饱和,进而以固定在坩埚顶部的籽晶为形核中心发生重结晶,形成碳化硅晶体[16]。该过程可以概括为三个阶段:
(1)升华阶段:SiC源材料在高温下发生升华,形成气态的Si和C化合物。
(2)气相传输阶段:升华的气态分子通过载气(通常为氩气)从高温区传输至较低温的衬底表面。
(3)沉积和晶体生长阶段:气态物质在衬底表面冷凝并反应,重新形成固态的SiC晶体。
目前使用利用 PVT 法生长碳化硅晶体的速率最高可达1-2 mm/h[17]。PVT法通过控制温度梯度、气氛和压强等条件,能够控制SiC晶体的生长速率、晶体质量及尺寸。
四、PVT法制备碳化硅的工艺影响因素
(1)温度分布
目前大规模产业化的物理气相传输法,以中频感应线圈为加热电源,在涡流作用下高密度石墨发热体将被加热。将SiC粉体填满石墨坩埚的底部,SiC籽晶粘结在距原料面有一定距离的石墨坩埚盖内部,然后将石墨坩埚整体置于石墨发热体中,通过调节外部石墨毡的温度,使SiC的原料置于高温区,而SiC籽晶相应的处于低温区。在超过2000℃高温下,碳化硅原料分解成升华的Si原子、SiC2分子以及Si2C分子等气相物质,气相物质在温度梯度的驱动下向低温区输送,在SiC籽晶的C面上生长成SiC晶体。通常,高温区的SiC源材料温度在2000℃以上,而衬底区的温度相对较低,形成的温度梯度驱动气相传输。温度梯度过大可能导致晶体内产生缺陷或裂纹,而梯度过小则会降低生长速率。如图4所示,SiC晶型在不同温度下有不同的相对占比,并且可以在一定温度下相互转化[18]。因此,PVT法的SiC晶体生长过程依赖于炉腔内的温度分布。李鹏程、陈彦宇、靳丽岩等人均对PVT设备中的温度分布进行了优化研究,通过调整线圈位置高度、坩埚旋转速率、加热功率、腔体形状和保温层设计等来优化腔体内的温度分布[19-21],进而减少微管、位错等缺陷,提高SiC的尺寸与品质。
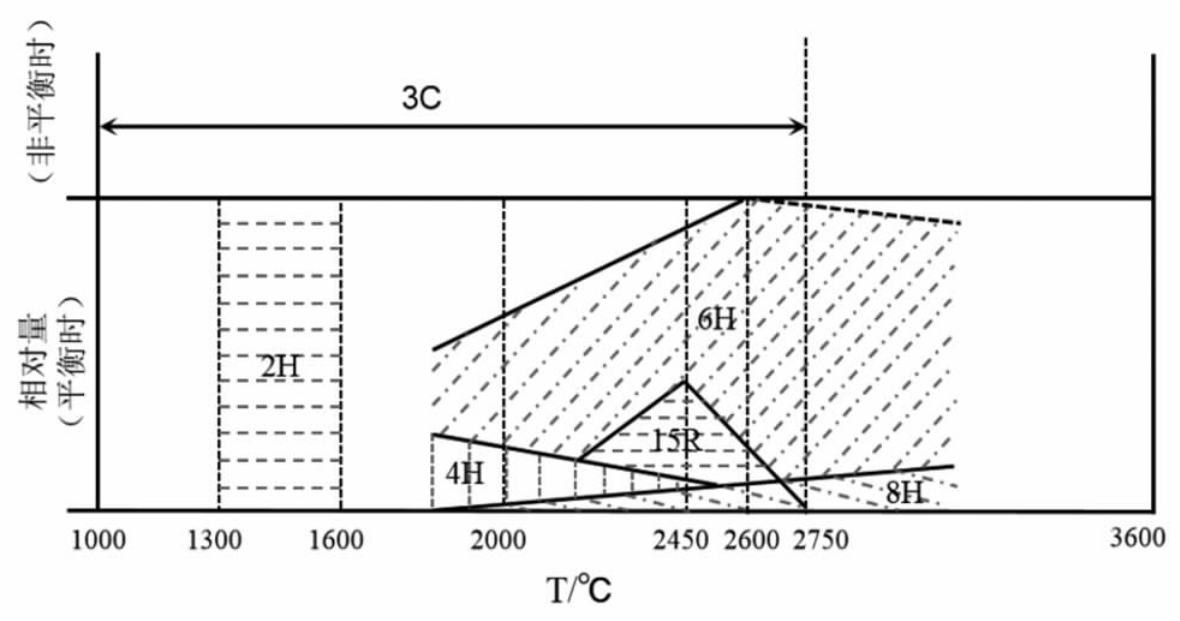
图4 PVT法生长SiC晶型与温度的关系[18]
(2)气氛控制
气相传输的气氛通常采用惰性气体如氩气。适当的气体流量和压力可以促进SiC分子的传输和沉积。气氛中的微量杂质(如氧或氮)可能与SiC发生反应,形成期望外的化合物,从而影响晶体质量[22]。郭金笛就通过掺杂氮气调节生成的SiC的硬度[23]。而YANG YING在采用 PVT法生长SiC时,则通过更精确地控制气氛,增加生长气体流量,避免N2的掺杂,使刃位错(TED)密度下降[24],提高了单晶SiC的质量。因此,严格控制气氛的纯净度至关重要。
(3)粉体纯度
SiC粉体作为合成原料会直接影响SiC单晶的生长质量和电学性质。陈之战等研究了SiC粉体在生长过程中的物相变化及对单晶均匀性、缺陷等的影响,发现在使用β-SiC粉体生长SiC单晶时,在晶体生长过程中存在着向α-SiC的相转变,造成气相组分中的Si / C摩尔比变化较大,对晶体生长产生不利影响。为了提高晶体均匀性,降低微管等缺陷,必须对原料进行预烧处理,一方面促使其晶型转变并增大粉体颗粒度,另一方面降低原料的杂质含量[25]。Shin等研究了不同粒径以及不同杂质含量的SiC粉体对SiC单晶生长的影响,发现单晶中大部分的杂质均来自SiC粉体,单晶的质量与粉体的纯度呈线性关系。高纯度粉体对于减少4H-SiC中基平面位错(BPD)的密度是有利的[26]。王殿、胡智臣、高攀、李斌、马康夫等人通过改进制备SiC粉体的工艺以及相关参数如温度、气氛等获得了较高纯度的碳化硅粉料[27-31],为后续生长大尺寸、低缺陷密度的高品质单晶SiC打下了重要的基础。
(4)腔体内的压强
系统的工作压力对升华过程和气相传输过程有直接影响。高真空少杂质,较低的压力有助于增加SiC的升华速率;但过低的压力可能会导致升华物质在传输过程中损失,影响晶体生长速率。一般压力范围为1-100托,需根据具体的生长目标进行优化,目前该方面的研究较少。
(5)生长时间
PVT法通常是一个长时间的晶体生长过程,生长时间通常在几十小时到上百小时不等。延长生长时间可以增加晶体的厚度,但同时也会增加热应力和缺陷生成的风险[32]。因此,合理的生长时间控制是保证晶体质量的关键。
五、PVT法制备碳化硅的结构与性能
通过优化PVT法的工艺参数,可以制备出不同晶型的SiC单晶,主要包括3C-SiC、4H-SiC和6H-SiC三种晶型。这些晶型的结构和性能差异使其适用于不同的应用领域。
3C-SiC是SiC中的一种立方晶型结构,带隙较小(约2.3 eV),电子迁移率较高,适用于高频电子器件。然而,3C-SiC晶体的制备难度较大,容易产生缺陷,限制了其应用。而4H-SiC是目前研究和应用最为广泛的SiC晶型[33-36],具有较大的带隙(约3.3 eV)和较高的击穿场强,适用于高功率、高温电子器件。因为4H-SiC晶体生长的稳定性较好,缺陷较少,是功率半导体器件的首选材料。6H-SiC也是一种常见的SiC多型结构,带隙约为3.0 eV,电子迁移率稍低于4H-SiC,但其生长技术较成熟,晶体质量高,广泛应用于光电器件和电子器件中。
六、PVT法制备SiC面临的困难与挑战
尽管PVT法在制备高质量碳化硅单晶方面取得了显著进展,但仍存在一些技术挑战需要克服,以进一步推动其应用。
首先是晶体缺陷控制。尽管PVT法能够制备出较大尺寸的SiC单晶,但当尺寸扩展到 8 英寸时, 热应力增大, 缺陷控制更加困难, 晶体中仍可能出现位错、堆垛层错和空位等缺陷[10,37]。这些缺陷会影响器件的电学性能和稳定性[38-40]。目前商用6英寸导电型4H-SiC衬底的TSD密度控制在200 cm–2 以下, 优品的TSD/BPD密度小于50 cm-2, BPD 密度在800 cm-2以下, 优品的TSD/BPD密度小于500 cm-2[41]。因此,如何通过优化工艺条件降低缺陷密度,是当前研究的重点。2022年, 山东大学与南砂晶圆成功制备了低微管密度高结晶质量的8英寸导电型 4H-SiC 单晶衬, 近期在8英寸SiC衬底位错缺陷控制方面又取得了重大突破, 制备了近零螺位错(TSD)和低基平面位错(BPD)密度的8英寸导电型 4H-SiC 单晶衬底[32]。
其次是应力控制。在PVT法的生长过程中,SiC单晶由于温度梯度和热膨胀系数差异,易产生热应力,进而导致晶体开裂或缺陷增加[42,43]。如何有效控制应力,避免晶体内部裂纹的形成,是提升SiC晶体质量的重要课题。
然后是大尺寸单晶SiC的制备。随着SiC在电子器件中的需求不断增长,制备更大尺寸(如8英寸、甚至12英寸)且高质量的SiC单晶成为一大挑战。扩大SiC衬底尺寸是增加产能供给、降低成本的重要途径之一。当前PVT法主要能够稳定制备4英寸和6英寸的SiC晶片,进一步扩大晶片尺寸仍需解决材料均匀性和生长速率问题。目前国内外的碳化硅单晶的直径已经普遍能达到6英寸[44-46],但其厚度通常在20~30 mm之间,导致一个碳化硅晶锭切片所获得的碳化硅衬底片的数量相当有限,增加碳化硅单晶厚度的主要挑战在于其生长时厚度的增加及源粉的消耗对生长室内部热场的改变。浙江大学杭州国际科创中心(简称科创中心)先进半导体研究院-乾晶半导体联合实验室通过提拉籽晶及已经生长的晶体,使晶体生长面始终处于一个合适的径向温度梯度下,形成有利于降低晶体应力的表面形态。采用提拉式物理气相传输法,联合实验室成功生长出直径为6英寸(即150 mm)的碳化硅单晶,其厚度突破了100 mm。测试加工而得的衬底片的结果显示,该超厚碳化硅单晶具有单一的4H晶型[47]。该厚度的实现,一方面节约了昂贵的碳化硅籽晶的用量,另一方面使一个碳化硅单晶锭切片所获得的碳化硅衬底片数量能够翻倍,可以大幅降低碳化硅衬底的成本,有望有力推动半导体碳化硅产业的发展。
另外,目前的单晶SiC衬底中,N型衬底较多,P型衬底进展较慢。P型的SiC是制备高功率电力电子器件的理想衬底,但电阻率很难降低,其P型掺杂技术仍在研究阶段。由于P型掺杂的难点,如受主电离能高导致衬底电阻率高;缺少合适的气体掺杂源,导致掺杂不均匀;受主元素蒸汽压高导致晶体中产生大量缺陷等使得生长P型体块SiC相对困难[48]。
最后,PVT法虽然相对成本较低,但在高温、高耗能的工艺条件下,依然存在生产成本高的问题,SiC 衬底的价格仍远远高于Si、蓝宝石等衬底。降低成本需要更加成熟的生长和加工技术,一方面需要提高衬底材料的成品率,另一方面则是要通过扩径研究增大面积,降低单个器件成本。因此,提高晶体生长速率、降低生产能耗的同时保证晶体质量,是未来工艺改进的关键方向。
六、总结与展望
SiC 器件因其具备高频高效、耐高压、耐高温、抗辐射能力强以及化学性质稳定等诸多优越性能,正被广泛应用于轨交、风电、光伏、新能源汽车、不间断电源等电力电子领域中[49]。物理气相传输法(PVT)作为碳化硅单晶制备的核心技术,已经在高功率电子器件和光电器件的材料制备中展现了巨大潜力。通过优化工艺条件、控制晶体缺陷和应力,PVT法能够制备出高质量的4H-SiC和6H-SiC单晶,这些单晶在高温、高压、高频器件中的应用前景广阔。然而,随着碳化硅在电子器件领域需求的不断增加,如何进一步提升晶体尺寸、降低成本以及控制晶体缺陷,将是未来研究的重点方向。
参考文献
[1] LANGPOKLAKPAM C, LIU A C, CHU K H, et al. Review of silicon carbide processing for power MOSFET[J]. Crystals, 2022, 12(2):245.
[2] VERMA J, PAN’T S, KUMAR A, et al. Analysis of trench termination in 4H-nsic based power devices[J]. Materials Today: Proceedings,2021,46:11072-11076.
[3] IANNACCONE G, SBRANA C, MORELLI I, et al. Power electronic based on wide -bandgap semiconductors: opportunities and challenges[J].IEEE Access,2021,9: 139446- 139456 .
[4] SINGH S, CHAUDHARY’T, KHANNA G. Recent advancements in wide band semiconductors(Sic and GaN) technology for future devices[J]Silicon,2022,14(11):5793-5800.
[5] 杨光.半导体碳化硅中位错的识别及其在单晶生长过程中的演变[D].浙江理工大学,2023.DOI:10.27786/d.cnki.gzjlg.2023.000790.
[6]石栋.超声辅助单晶SiC晶片的研磨与化学机械抛光研究[D].吉林大学,2019.DOI:10.27162/d.cnki.gjlin.2019.000126.
[7] D. Nakamura, et al. Growth of High-Quality SiC Single Crystals by PVT Method[J]. Journal of Crystal Growth, 2018.
[8] K. Nishino, et al. Defect Control in SiC Crystals Grown by Physical Vapor Transport [J]. Materials Science Forum, 2020.
[9] CHENG L, PALMOUR J W, AGARWAL A K, et al. Strategic overview of high-voltage SiC power device development aiming at global energy savings[J].Materials Science Forum, 2014, 778: 1089.
[10] LANG G Q, QIAN H, SU YL, e al. Review of solution growth techniques for 4H-sic single crystal [J]. china Foundry, 2023 , 20(2) : 159.178.
[11] MORVAN E, KERLAIN A, DUA C, et al. Influence of material properties on wide bandgap microwave power device characteristics[J]. Materials Science Forum, 2003, 433: 731.
[12] LIU Y L. Recent progress on single-crystal growth and epitaxial growth of 4H silicon carbide[J]. Solid State Phenomena, 2022, 332: 73-84.
[13] 顾鹏,雷沛,叶帅,等.顶部籽晶溶液法生长碳化硅单晶及其关键问题研究进展[J].人工晶体学报,2024,53(05):741-759.DOI:10.16553/j.cnki.issn1000-985x.20240320.007.
[14] L. Neudeck, et al., “Advances in SiC PVT Crystal Growth for High-Power Device Applications,” Journal of Electronic Materials, 2022.
[15]李鹏程.大尺寸碳化硅单晶生长设备及温控方法研究[D].山东大学,2022.DOI:10.27272/d.cnki.gshdu.2022.005629.
[16] Kimoto T. Bulk and epitaxial growth of silicon carbide [J]. Progress in Crystal Growth and Characterization of Materials, 2016, 62(2): 329-51.
[17] Wellmann P J. Power Electronic Semiconductor Materials for Automotive and Energy Saving Applications – SiC, GaN, Ga2O3, and Diamond [J]. Z Anorg Allg Chem, 2017, 643(21): 1312-22.
[18] 马原原,刘军,张雅丽,等.大直径SiC单晶材料的应用及前景分析[J].山东化工,2021,50(14):177-178.DOI:10.19319/j.cnki.issn.1008-021x.2021.14.072.
[19] 李鹏程,冯显英,李沛刚,等.大尺寸碳化硅单晶生长环境研究[J].半导体光电,2021,42(05):672-677.DOI:10.16818/j.issn1001-5868.2021071201.
[20] 陈彦宇.PVT法碳化硅单晶生长炉的热场仿真与优化研究[D].哈尔滨工业大学,2022.DOI:10.27061/d.cnki.ghgdu.2022.004085.
[21] 靳丽岩,王毅,王宏杰,等.基于8英寸的碳化硅单晶生长炉技术[J].电子工艺技术,2024,45(03):46-49+62.DOI:10.14176/j.issn.1001-3474.2024.03.012.
[22] 张家鑫,彭燕,陈秀芳,等.碳化硅单晶位错研究进展[J].人工晶体学报, 2022, 51(11): 1973-1982. DOI:10.16553/j.cnki.issn1000-985x.2022.11.014.
[23]郭金笛.碳化硅基半导体材料硬度及热导率研究[D].山东大学,2021. DOI:10.27272/d.cnki.gshdu.2021.000886.
[24] YANG YING, LIN TAO, CHEN ZHIMING. Effect of growth gas flow rate on the defects of SiC single crystal[J]. Chinese Journal of Semiconductors,2008,29(5):851-854.
[25] 陈之战,施尔畏,肖兵,等.原料对碳化硅单晶生长的影响[J].无机材料学报,2003,18(4) : 737-743.
[26] SHIN D G,SON H R, HEO S, et al. Impurity behavior of high purity SiC powder during SiC crystal growth[J].Materials Science Forum, 2014, 778 /779 /780: 22-25.
[27] 王殿,郭立梅,王飞龙,等.高纯度碳化硅单晶粉料合成工艺[J].电子工艺技术,2024,45(01):46-50.DOI:10.14176/j.issn.1001-3474.2024.01.013.
[28] 胡智臣.第三代半导体SiC单晶生长用高纯SiC粉制备研究[D].南昌大学,2023.DOI:10.27232/d.cnki.gnchu.2023.003583.
[29] 高 攀,刘 熙,严成锋,等.用于SiC晶体生长的高纯原料的合成及性能研究[J].人工晶体学报,2013,42(5) :819-823.
[30] 李 斌,马康夫,王英民,等.高真空下合成生长单晶用高纯碳化硅粉料[J].电子工艺技术,2017,38(3) :164-167
[31] 马康夫,王英民,李 斌,等.通H2合成生长单晶用高纯碳化硅粉料[J].电子工艺技术,2016,37(4) :187-190.
[32] 熊希希,杨祥龙,陈秀芳,等.低位错密度8英寸导电型碳化硅单晶衬底制备[J].无机材料学报,2023,38(11):1371-1372.
[33] 杨光.半导体碳化硅中位错的识别及其在单晶生长过程中的演变[D].浙江理工大学,2023.DOI:10.27786/d.cnki.gzjlg.2023.000790.
[34] 丁祥,钱昊,梁刚强,等.高温溶液法生长4H–SiC单晶的助溶剂研究进展[J].硅酸盐学报,2024,52(07):2425-2441.DOI:10.14062/j.issn.0454-5648.20240139.
[35]王沛志.单晶碳化硅的金刚石线锯切片表层裂纹损伤研究[D].山东大学,2020.DOI:10.27272/d.cnki.gshdu.2020.000072.
[36]邓招鹏.单晶SiC超声辅助划擦和磨削特性研究[D].华侨大学,2022.DOI:10.27155/d.cnki.ghqiu.2022.000556.
[37] DUDLEY M, HUANG X R, HUANG W, et al. The mechanism of micropipe nucleation at inclusions in silicon carbide[J]. Applied Physics Letters, 1999, 75(6): 784-786.
[38] KATSUNO T, WATANABE Y, FUJIWARA H, et al. Analysis of surface morphology at leakage current sources of 4H-SiC Schottky barrier diodes[J]. Applied Physics Letters, 2011, 98(22): 222111.
[39] YAMAMOTO K, NAGAYA M, WATANABE H, et al. Influence of threading dislocations on lifetime of gate thermal oxide[J]. Materials Science Forum, 2012, 717 / 718 / 719 / 720: 477-480.
[40] KIMOTO T. Material science and device physics in SiC technology for high-voltage power devices[ J]. Japanese Journal of Applied Physics,2015, 54(4): 040103.
[41] YANG G, LIU X S, LI J J. et al. Dislocations in 4H silicon carbide single crystals[J]. Journal of Synthetic Crystals, 2022, 51(9): 1673.
[42]邓亚,张宇民,周玉锋.X射线衍射法测量碳化硅单晶的残余应力[J].力学学报,2022,54(01):147-153.
[43] XIE X J, HU X B, CHEN X F, et al. Characterization of the three-dimensional residual stress distribution in SiC bulk crystals by neutron diffraction[J]. CrystEngComm, 2017, 19(43): 6527-6532.
[44]MAKAROV Y N, LITVIN D, VASILIEV A, et al. Sublimation growth of 4 and 6 inch 4H-SiC low defect bulk crystals in Ta (TaC) crucibles[J]. Materials Science Forum, 2016, 858: 101.
[45] CHOI J W, KIM J G, JANG B K, et al. Modified hot-zone design for large diameter 4H-SiC single crystal growth[J]. Materials Science Forum, 2019, 963: 18.
[46] PENG Y, CHEN X F, PENG J, et al. Study on the growth of high quality semi-insulating ϕ150 mm 4H-SiC single crystal[J]. Journal of Synthetic Crystals, 2016, 45(5): 1145.
[47] 编辑部.浙江大学50 mm厚6英寸碳化硅单晶生长获得成功[J].粉末冶金工业,2022,32(05):141.
[48]彭燕,陈秀芳,谢雪健,等.半绝缘碳化硅单晶衬底的研究进展[J].人工晶体学报,2021,50(04):619-628.DOI:10.16553/j.cnki.issn1000-985x.2021.04.005.
[49]麦玉冰,谢欣荣.第三代半导体材料碳化硅(SiC)研究进展[J].广东化工,2021,48(09):151-152+155.